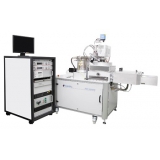
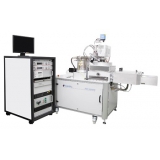
电感耦合等离子体化学气相沉积系统是为等离子化学蚀刻系统应用设计的反应离子蚀刻RIE和ICPCVD系统,将反应离子刻蚀RIE和电感耦合等离子体刻蚀ICP两种等离子体化学刻蚀模式相结合.
该电感耦合等离子体化学气相沉积系统充分利用了半导体、电介质和金属薄膜受控等离子体刻蚀工艺的所有必要特性。它适用于氯和氟化学。STE ICP200E允许两种类型的等离子体激发:电容(冷却基板电极)和电感(平面螺旋ICP电极)。
电感耦合等离子体化学气相沉积系统改进的小反应器容积和*化的供气系统可以显著提高工艺的均匀性和再现性,并缩短泵送时间。*新的反应器是***佳的蚀刻配方与快速变化的工艺气体(博世过程)。由于可以方便地访问所有内部组件,因此系统的日常维护变得*加容易。特殊的底部电极设计为蚀刻工艺提供高效的氦冷却和晶圆温度控制。
电感耦合等离子体化学气相沉积系统允许在较宽的工艺参数窗口内,将反应离子刻蚀RIE和电感耦合等离子体刻蚀ICP两种等离子体化学刻蚀模式相结合。射频发生器自动匹配,从而确保稳定的等离子燃烧模式在广泛的功率值范围内。系统设计为其配置提供了解决单个客户任务的广泛机会。
电感耦合等离子体化学气相沉积系统规格参数
工艺过程反应器中的极限压力: <5×10-6Torr
一次性处理晶圆数量::7个@2'', 4个@3'', 1个×∅200mm, 1个@∅150mm 1个@∅100mm
RIE反应器***大功率:600W @13.56MHz
ICP发生器***大功率:1200W @13.56MHz
晶圆冷却温度范围:-30℃~80℃
达到预处理真空的时间(<5×10^-6Torr): 不超过25min
磁控管源的***大数量:5×∅200mm 或 6×∅150mm
离子束粒(离子能20~300eV): 可选配
衬底支架倾斜180度: 可选配
蚀刻不均性:+/-2% (从中心位置到边缘,∅100mm)
过程:自动化把晶圆转移到反应器中。



